新規事業・商品企画から研究開発推進、現場の課題解決・改善、そして、人材育成まで
ジャパン・リラーチ・ラボ(JRL)は、明日の飛躍をお手伝いいたします。

走査型電子顕微鏡(SEM)の原理・特徴
(SEM:Scanning Electron Microscope)

SEMは、電子線を電場レンズによって細く絞りながら、試料表面上を走査させて、表面から発生する二次電子や反射電子を検出して試料表面の顕微鏡像を得る。そして、二次電子や反射電子と同時に放出される特性X線を利用して元素分析も行うことも可能である(SEM-EDX)。
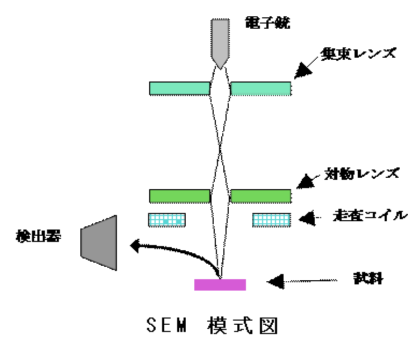
特徴は、光学顕微鏡と比較して焦点深度が二桁以上深いことから、広い範囲にわたってピントの合った立体的な像を得る事ができる点があげられる。しかし、対象物の表面形状は把握しやすいが、対象物の内部に関する情報は基本的に得られない。ただし、切断や研磨、破断などの方法で断面を出すことで内部観察も可能である。
この深い焦点深度を利用する方法として、対物絞りや試料距離の調整がある。一般的な装置には、対物レンズ内あるいは対物レンズの上部に固定または可動型の絞りが取り付けられており、使用者が絞り径を選択することができる。絞り径を小さくすることは、試料に照射する電子線の一部をカットしていしまうことになるが、電子線の形状はよりシャープになり、大きな焦点深度がえられる。さらに、対物レンズと試料間の距離(ワーキングディスタンス:WD)とを大きくして小さな絞り径を使用すると、照射電子線はさらにシャープなものとなり極めて大きな焦点深度が得られる。ただし対物レンズから試料面の距離が大きくなることは分解能の低下を伴うので注意が必要である。
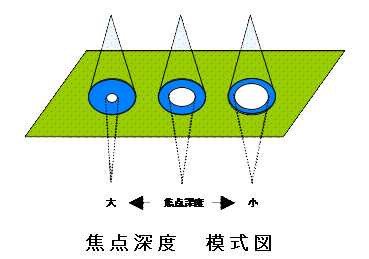
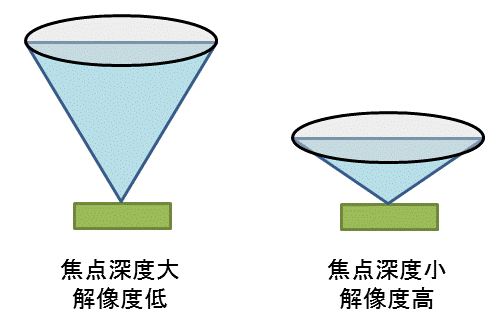
WD(試料距離)とフォーカス
通常、SEM観察においては電子線照射によって試料表面で発生した2次電子を検出するが、この2次電子像においてコントラストが発生することがある。2次電子像のコントラスト発生の代表的要因としては、試料表面の凹凸によるものがあげられる。これは、エッジ効果と呼ばれる現象によるものであり、試料表面の凹凸によって2次電子の放射効率が異なることによる。

このほかにもコントラストが発生する要因として、試料の構成元素の違いがあげられる。ただし、一般に反射電子の放出は原子番号が大きくなるにしたがって増大するが、2次電子の放出については必ずしも原子番号の順ではないことから、2次電子像で明るい部位が暗い部位に比べて平均原子番号が大きいとは単純に結論できない点には注意が必要である。しかし、簡易的に組成差を評価する目的では、測定も簡便であることから有効な方法であり、特に、予め組成が分かっており、それがコントラストを生むような組成差であった場合には、例えば、層構成や膜厚評価など形状的な評価目的の場合には十分な機能であると言える。もちろん、さらにEDX検出器などと組み合わせれば定性分析も含めた詳細な解析が可能である。
試料表面の凹凸や組成以外にも二次電子像のコントラストを形成する要因が存在する。その一つが、試料表面の電位差に依存するものであり、いわゆるチャージアップによるものである。例えば有機材料や生体試料などの非導電性試料を観察する時に、照射された電子が蓄積し、試料表面が帯電する例などがあげられる。これが、試料からの二次電子の放出に影響を与え,異常なコントラストを示すことがある。これを避けるためには、試料表面に金属やカーボンなどの導電物質をコーテイン グするか、加速電圧を低くして試料が帯電しにくいようにする必要がある。ただし、半導体デバイスなどでは,逆にこの電位差コントラストを利用して,デ バイスの診断が行われる場合もある。
焦点深度以外の観察結果に与える影響が大きいものとして、照射電子線の加速電圧があげられる。一般には、加速電圧が高いほど電子線を絞る事ができるので高分解能測定には有利であり、低加速電圧では十分に観察倍率をあげる事ができない。しかし、加速電圧を高くすると電子線はより深くまで進入するために、表面近傍の極薄領域の情報が失われてしまうことがある。したがって、表面に存在する極薄い領域の測定を行う時には、照射電子線の加速電圧の設定に注意を払う必要がある。ただし、最近では超低加速電圧でも高倍率の測定が可能な装置も開発されているので、目的に応じて使い分けることが重要である。

主な用途は、無機物から有機物、生体関連まで、非常に幅広い材料の表面形態観察に用いられる。ただし、電子線を用いることから、絶縁物を観察する時には、カーボンや金などを蒸着して導通を確保しなれければならない場合がある。
そして、最近では試料室を低真空状態に保ったままで測定可能な低真空SEMも開発されており、その応用範囲が広がっている。例えば、従来は非導電性のため金属膜などを蒸着する必要があった試料も、そういった前処理を行うことなく測定できるようになったり、生体試料など、(若干の)水分や油分を含んだような試料であっても測定可能となってきている。
さらに、装置自体も非常に小型のものが開発されており、事務机程度のスペースがあればPCステーションも含めて設置可能であったり、簡単に移動ができるもの、冷却水などの用役が不要で商用電源(100V)のみで使用可能なものなどより使いやすくなってきている。
また、従来のSEMにおける課題の一つとして、凹凸の判別が困難であるという点があった。凹凸の存在はもちろん明確に判別できるのであるが、それが山であるのか、谷であるのかという点の区別が困難なのである。しかし、最近になって試料傾斜を自動制御しながら複数画像を取得し、それらを数学的に合成することで3D像を得ることができる3D-SEMが開発されている。これを用いることによって、SEMの特徴である広い分解能レンジと深い焦点深度を利用した立体形態観察が可能となり、さらにその活用幅が広がってきている。

ご相談、お問い合わせは、まずは下記までお気軽にお問い合わせ下さい

総合技術コンサルティング&人材育成
ジャパン・リサーチ・ラボ











